
膜厚測定装置 TohoSpec3100
高精度膜厚測定のスタンダード機として長年の信頼と実績を持つNanoSpec3000シリーズ(旧Nanometrics社製)の正式後継機としてTohoSpec3100シリーズをご提案。より操作性の高いソフトウェアへの更新など、さらに利便性が向上した新たなスタンダード機を是非ご活用ください。
TohoSpecシリーズに関するお問合せ・ダウンロードはこちら
TohoSpec3100とは?
対物レンズを介してサンプルに光を垂直に入射させ、その反射光を分光し、各波長毎の反射強度データを取得します。その反射スペクトルと作成した測定モデルの反射スペクトルでフィッティングを行い膜厚値を出力します。
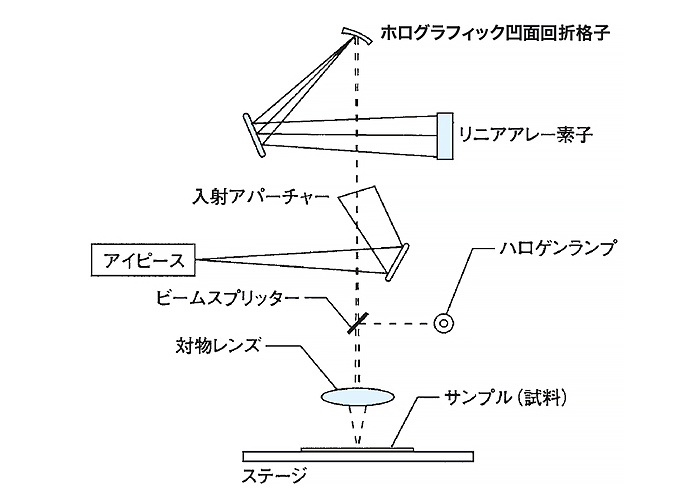
特徴1: NanoSpecの正式後継機
Nanometrics社(現Onto Innovation社)が製造・販売していたNanoSpec3000シリーズの事業移管を受け、その正式な後継機として2014年よりTohoSpec3100シリーズの製造・販売を開始しました。測定性能はそのままに、ソフトウェアを刷新、よりお客様のニーズに合わせた仕様変更を行っています。
NanoSpec3000からのレシピ移植も可能のため、装置更新が容易に行えます。

特徴2: 高度な測定性能
単層膜はもちろん、最大3層までの多層膜の測定に対応しています。膜厚測定と同時に光学定数(n, k)の測定も行い、より精度の高い膜厚測定が可能となっております。ソフトウェアには多くの測定モデルを搭載しており、サンプル膜質、構造に合った最適モデルを作成でき、屈折率が近接した膜や基板との界面であっても高度な解析機能により分離測定が可能です。測定時間は通常1秒以内に完了し、お待たせすることなく測定結果を確認することができます。
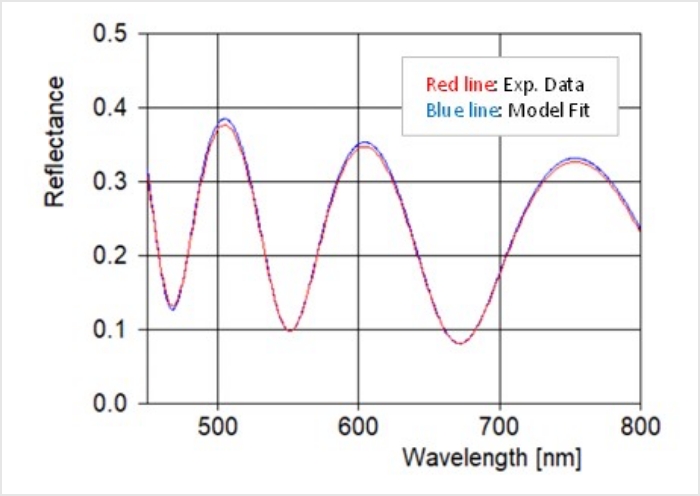
特徴3: スモールスポット測定
標準仕様では5倍の対物レンズを搭載しています。お客様の用途に合わせて10倍、50倍の対物レンズをオプションで選択可能。TohoSpec3100Tモデルでは100倍の対物レンズも選択可能で測定スポットサイズを0.75umまで絞った微小エリアでの測定が可能です。透明基板上の膜厚測定では高倍の対物レンズを使用することで基板裏面からの反射の影響を小さく(無視)することができ、より精度の高い測定が可能となります。

用途・アプリ
-
続きを読む
-
1半導体プロセス開発
半導体プロセスでのウェーハ上の膜厚測定にお使いいただけます。成膜条件によりその膜質が変化するため、それぞれの膜質に合わせた高精度な膜厚測定はプロセス開発において非常に重要な要素となります。

2ディスプレイプロセス開発
半導体プロセス同様にディスプレイプロセスにおいても多くの成膜工程があり、その膜厚分析、管理は重要です。半導体プロセスでのシリコン基板とは異なり、透明なガラス基板を使用するディスプレイプロセスではガラス基板の裏面からの反射をいかに対処するかが重要となります。
TohoSpec3100Tモデルでは最大100倍までの対物レンズを提案しており、透明基板に対してもより高精度な膜厚測定が可能となっています。
製品ラインナップ・概要仕様
-
続きを読む
-
スタンダードモデル
モデル TohoSpec3100 基板サイズ 3~8インチ 厚測定範囲 10nm ~ 30um *1 対物レンズ 5倍 (Φ50um) 測定再現性 ±2A 又は ±0.1% の大きい方 *1*2 オプション 10倍(Φ25um)、50倍(Φ5um)、USBカメラ 
高分解モデル
モデル TohoSpec3100T 基板サイズ 3~8インチ 厚測定範囲 10nm ~ 70um *1 対物レンズ 5倍 (Φ15um) 測定再現性 ±2A 又は ±0.1% の大きい方 *1*2 オプション 50倍(Φ1.5um)、100倍(Φ0.75um)、USBカメラ 
*1: 測定膜種、サンプル構造による
*2: 同一ポイントの15回測定とする
FAQ よくあるお問い合わせ
-
測定可能なウェーハサイズは?
-
3インチから8インチまでのサンプル測定が可能です。
-
フィルターを使って測定は可能ですか?
-
イエローフィルターが標準付属していますので必要に応じてお使いいただけます。
-
測定できる膜種は?
-
透明、半透明膜の膜の膜厚測定が可能です。
-
多層膜の測定が可能ですか?
-
標準的に3層膜までの膜厚測定が可能です。
-
膜厚以外にも測定が可能ですか?
-
膜厚と同時に光学定数(n, k)の測定が可能です。その他、絶対反射率の測定ができます。
-
海外への販売、サービスも可能ですか?
-
中国、台湾、韓国、東南アジア、アメリカ、ヨーロッパなどでも現地サポートが可能です。ご相談ください。



